High Heat Dissipation Materials
Overview

- - KOSTECSYS SPS diffusion bonding technology is a core semiconductor material technology with high thermal conductivity and low thermal expansion coefficient.
- * KCMC® (Kostec Copper Molybdenum Composite) : KOSTEC Brand, Trademark Registration - 4020240019848, Patents - 1014925220000, 1024923060000
| Material | Compositions (vol %) | Layers | Thermal Expansion [ppm/˚C] | Thermal Conductivity[W/(m.K)]25℃ (Z-direction) |
||
|---|---|---|---|---|---|---|
| Molybdenum | Copper | 150˚C | 300˚C | |||
| KCMC®12 | 12 | 88 | 3, 5, 7 | 11.05 | 9.01 | 320 |
| KCMC®20 | 20 | 80 | 9.12 | 7.69 | 291 | |
| KCMC®28 | 28 | 72 | 8.83 | 7.57 | 263 | |
| KCMC®33 | 33 | 67 | 7.83 | 6.96 | 241 | |
| KCMC®40 | 40 | 60 | 7.34 | 6.59 | 222 | |
| CPC141 | 46 | 54 | 3 | 8.20 | 7.94 | 227 |
※ The Molybdenum composition and layer can be customized according to customer requests.
Features
- Low Thermal Expansion & High Heat Dissipation
- Low Thermal Stress
- High Reliability Semiconductors
- CTE Matched Materials
Thermal Cycle Stress caused by Thermal Mismatch
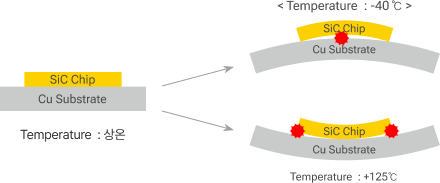
Thermal Stress in the semiconductor soldering area (Thermo-mechanical simulation data)

- Cu : Thermal Stress is “127” very high
- KCMC® : Thermal Stress is “41~69” low
Semiconductor Delamination caused by Thermal Mismatch
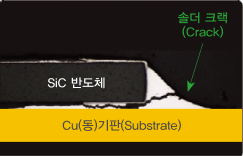

 ENG
ENG  KOR
KOR
